閱讀說明:本文是第一手資訊整理與產業知識分享,不構成任何投資建議。文章保留公司名稱,是為了讓讀者知道訊息來自哪些公司官網;每家公司只放一個代表性原始 URL,避免文章變成引用清單。
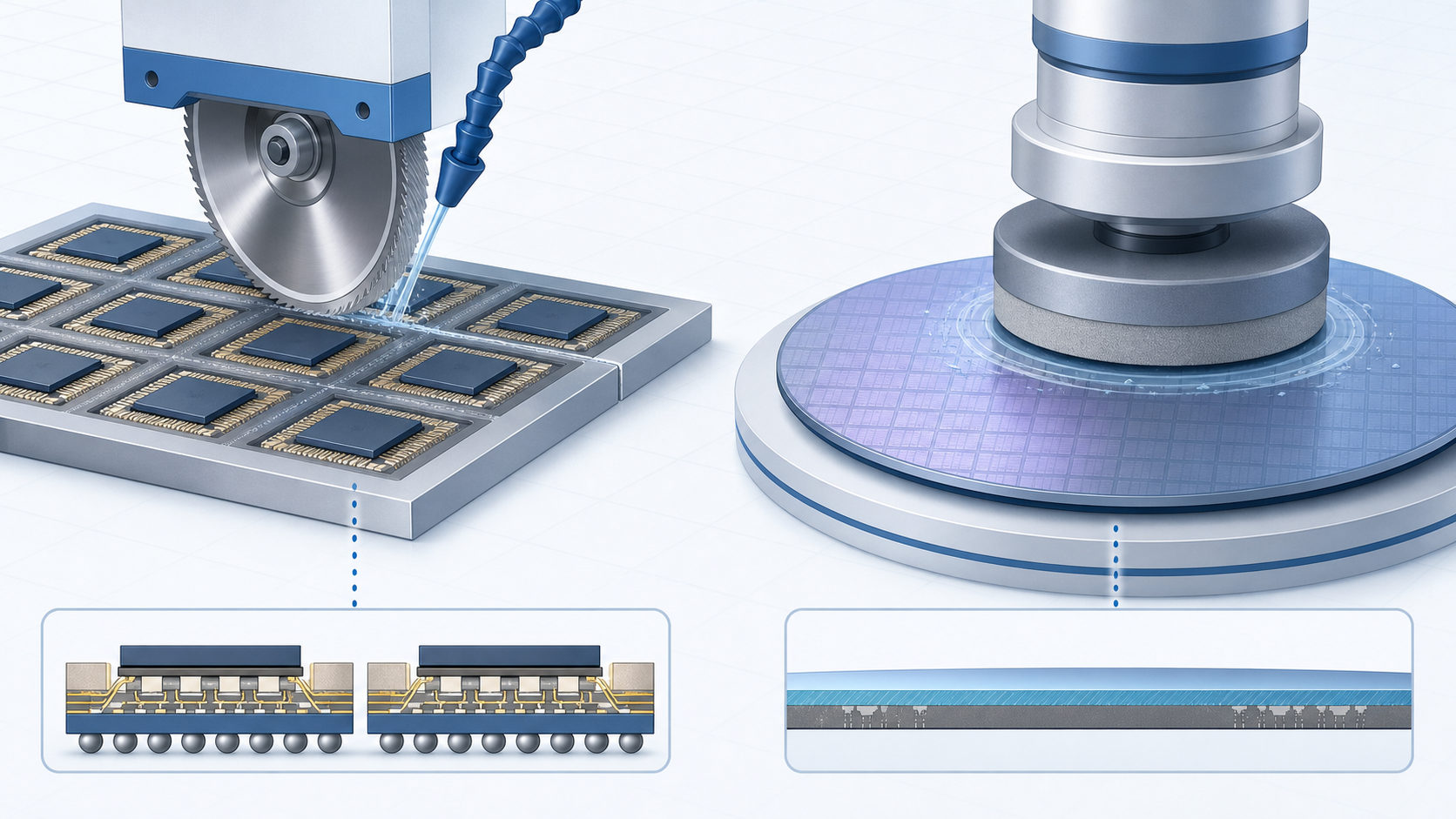

AI/HPC 晶片讓先進封裝的壓力從「把晶片接起來」延伸到「把更大的封裝切得準、磨得薄、膠點得穩、熱帶得走」。這也是為什麼封裝設備不只看 bonding 或檢測,還要看切割、研磨、點膠與散熱片貼合這些後段加工節點。
這篇先用四家第一手資料做設備鏈初稿:日本 DISCO,台灣中國砂輪、萬潤與竑騰。它們分別落在切割 / 研磨設備與耗材、點膠設備、散熱片與銦片貼合設備。這不是推薦名單,而是用來建立「AI 封裝變大變熱後,哪些製程環節會被拉動」的觀察框架。
一、封裝尺寸變大,切割不只是切晶圓
DISCO 在 2025 年底發表 DFD6080 package dicing saw,重點不是單純多一台切割設備,而是它支援最大 400 x 400 mm 的 package dicing。DISCO 自己在開發背景中提到,AI 與 DX 推動半導體需求,FOWLP 已普及,而使用大型面板的 PLP 也在進展中。這代表切割需求正在從傳統晶圓切割,延伸到更大尺寸、更複合材料的封裝切割。
這裡值得注意的訊號是:先進封裝一旦往更大載板、更多 chiplet、更高產出效率前進,後段切割設備就不只是附屬製程,而是良率、產能與成本的控制點。DISCO 的資料也顯示,設備需要處理樹脂基板、玻璃基板、lead frame 等複合材料,這讓切割能力更接近材料與封裝結構問題,而不是單純機械加工問題。
二、雷射切割與研磨,反映低損傷與薄型化需求
DISCO 另一個值得追蹤的訊號是 laser saw 出貨累計超過 4,000 台。公司說明中提到,2020 年累計出貨達 2,000 台,之後只花 6 年再增加 2,000 台,出貨速度明顯加快。這背後的原因,是高效能 logic、高密度 memory、HBM 與功率半導體都需要更低損傷、更高精度的加工。
研磨也有類似邏輯。DISCO 的 DFG8561 grinder 針對 300 mm wafer thinning,開發背景提到 wafer thinning 已是 back-end / OSAT 的標準製程,用來支援薄型化與更高整合度。換句話說,AI/HPC 封裝不只增加前段設備或先進封裝設備需求,也會拉動後段薄化、研磨、拋光等加工環節。
三、中國砂輪是台灣端的切割與研磨耗材觀察點
台灣端可以先看中國砂輪。它的精密鑽石切割刀產品頁明確寫到,應用包含印刷電路板與半導體封裝材料的切割;晶圓研磨砂輪頁面則標示應用於 TSV 封裝、SiC、藍寶石、矽與再生晶圓等直立式進給研磨加工。
這家公司在這篇文章中的角色不是「設備主機」,而是切割與研磨耗材。這一點很適合放在 DISCO 後面看:如果封裝尺寸變大、材料變複合、薄化與切割難度提高,耗材端要追蹤的不是單純出貨量,而是刀具、砂輪、鑽石粒度、壽命、材料移除率與加工穩定性。
四、點膠從小配角變成封裝可靠度節點
萬潤的新產品分類把矽光子製程、散熱製程、貼合製程、點膠製程、光學檢量測與自動化整合服務放在同一個產品地圖裡。這個分類方式本身就透露一件事:先進封裝設備商不再只是單點機台,而是圍繞散熱、貼合、點膠、檢測與自動化整合去組合能力。
以萬潤的自動點膠機為例,公司產品頁說明它用於 Flip chip 產品,將膠材填充至 die 與基板之間,並搭配預熱、點膠、保溫、收料流程。對 AI/HPC 封裝來說,點膠不是小工序,因為膠材填充、位置控制、溫度與產能都會影響封裝可靠度與量產穩定性。
五、散熱片與銦片設備,是 AI 晶片熱密度升高後的台灣線索
竑騰的 DS3200 先進銦片製程暨散熱片全流程機,是這次主題裡最直接對應 AI 晶片熱管理的來源。產品頁列出的 package size 為 FCBGA 8x8 到 135x135 mm,產品類別包含 FCBGA / FCCSP / FCLGA;適用範圍則涵蓋 Flux Jetting、植銦貼合、點膠與散熱片貼合。
這裡的重點是「熱」已經進入封裝設備鏈。AI/HPC 晶片功耗上升後,散熱片、熱介面材料、銦片與貼合精度會變成後段封裝的一部分,而不是只在系統散熱端處理。竑騰的設備功能中包含 CCD 檢測、Laser 測高、植銦對位、散熱片對位與熱壓合,代表散熱片貼合也在走向更高精度與自動化。
接下來可以觀察什麼
第一,看封裝尺寸是否持續放大。DISCO 的 package dicing 與 panel-level packaging 訊號,適合用來追蹤大尺寸封裝加工需求。
第二,看薄化、低損傷與複合材料加工是否變成主流要求。這會同時影響 DISCO 這類設備商,以及中國砂輪這類切割與研磨耗材商。
第三,看台灣設備商是否能從單點機台走向整段製程。萬潤與竑騰的價值,不只在點膠或貼散熱片,而在是否能和客戶封裝流程、檢測、自動化與資料介面整合。
第四,看「熱」是否變成先進封裝的固定投資主題。AI 晶片越大、功耗越高,散熱片、熱介面、銦片與貼合精度就越值得追蹤。
本篇整理
如果第一期要做設備分類文章,這個主題適合放在「設備」分頁。它的主軸不是單一公司新聞,而是把日本設備商與台灣設備 / 耗材商放在同一條封裝加工鏈上:DISCO 看切割與研磨主機,中國砂輪看切割與研磨耗材,萬潤看點膠與散熱製程設備,竑騰看銦片與散熱片貼合設備。
用這個角度看,AI 封裝的變化不只在 CoWoS 產能,也藏在封裝變大、變薄、變熱之後,每一道要把材料加工到位的設備與耗材節點。
代表來源
- DISCO News:Development of DFD6080 package dicing saw。來源類型:公司 News。URL:https://www.disco.co.jp/eg/news/corp/20251215_1.html
- 中國砂輪:精密鑽石切割刀。來源類型:Products。URL:https://www.kinik.com.tw/zh-tw/Products/DicingBlade.html
- 萬潤:產品資訊。來源類型:Products。URL:https://www.allring-tech.com.tw/product.htm
- 竑騰:先進銦片製程暨散熱片全流程機。來源類型:Products。URL:https://www.hta.com.tw/article_d.php?id=287&lang=tw&tb=2